集成電路封裝詳解,集成電路封裝流程-KIA MOS管
信息來源:本站 日期:2025-04-21
集成電路,簡稱IC,是一種微型電子器件或部件,通過特定工藝將電路所需的晶體管、電阻、電容和電感等元件及布線互連,集成在一小塊或幾小塊半導(dǎo)體晶片或介質(zhì)基片上,再封裝在一個(gè)管殼內(nèi),從而形成具有特定電路功能的微型結(jié)構(gòu)。
集成電路封裝是一種保護(hù)半導(dǎo)體元件免受外部物理損壞或腐蝕的方法,通過將它們包裹在陶瓷或塑料制成的封裝材料中。
集成電路封裝是指將制備合格芯片、元件等裝配到載體上,采用適當(dāng)連接技術(shù)形成電氣連接,安裝外殼,構(gòu)成有效組件的整個(gè)過程,封裝主要起著安放、固定、密封、保護(hù)芯片,以及確保電路性能和熱性能等作用。
根據(jù)切割與封裝順序劃分:傳統(tǒng)封裝(先從晶圓上分離出單個(gè)芯片后再進(jìn)行封裝);晶圓級封裝(WLP,在晶圓級上進(jìn)行部分或全部封裝工藝,再切割成單件)。
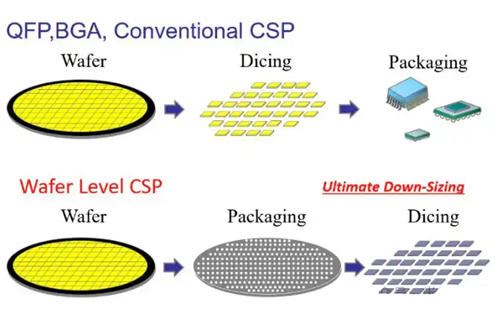
封裝,英文為Package,是指將工廠生產(chǎn)的集成電路裸片放置在承載基板上,通過引腳連接并固定包裝成一個(gè)完整器件的過程。
以DIP封裝為例,合格的裸片被緊貼安放在具有承托固定作用的基底上,基底上通常覆蓋一層散熱良好的材料。隨后,通過多根金屬線將裸片上的金屬接觸點(diǎn)與外部管腳焊接連接,再埋入樹脂并用塑料管殼密封,從而形成完整的芯片。
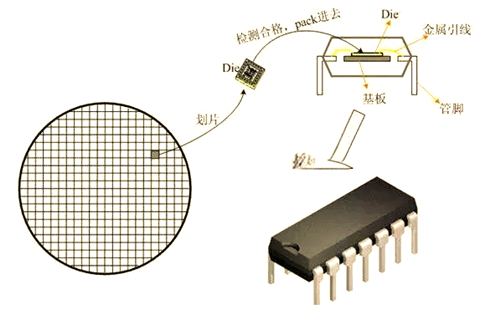
典型的封裝工藝流程
磨片:磨片之前,在硅片表面貼一層保護(hù)膜以防止磨片過程中硅片表面電路受損。磨片就是對硅片背面進(jìn)行減薄,使其變薄變輕,以滿足封裝工藝要求。磨片后進(jìn)行卸膜,把硅片表面的保護(hù)膜去除。
劃片(Dicing):在劃片之前進(jìn)行貼膜,就是要用保護(hù)膜和金屬引線架將硅片固定。再將硅片切成單個(gè)的芯片,并對其檢測,只有切割完經(jīng)過檢測合格的芯片可用。
裝片(Die Attaching):將切割好的芯片從劃片膜上取下,將其放到引線架或封裝襯底(或基座)條帶上。
鍵合(Wire Bonding):用金線將芯片上的引線孔和引線架襯墊上的引腳連接,使芯片能與外部電路連接。
塑封(Molding):保護(hù)器件免受外力損壞,同時(shí)加強(qiáng)器件的物理特性,便于使用。然后對塑封材料進(jìn)行固化(Curing),使其有足夠的硬度與強(qiáng)度經(jīng)過整個(gè)封裝過程。
電鍍(Plating):使用Pb和Sn作為電鍍材料進(jìn)行電鍍,目的是防止引線架生銹或受到其他污染。然后根據(jù)客戶需要,使用不同的材料在封裝器件表面進(jìn)行打印(Marking),用于識別。
切筋/打彎(Trimming/Forming):去除引腳根部多余的塑膜和引腳連接邊,再將引腳打彎成所需要的形狀。
測試∶全面檢測芯片各項(xiàng)指標(biāo),并決定等級。
集成電路的封裝方式多種多樣,每種方式都有其獨(dú)特的應(yīng)用和優(yōu)勢。常見的封裝類型包括雙列直插式封裝、四邊扁平式封裝、球柵陣列式封裝等。每種封裝方式都有其特定的技術(shù)要求和適用場景,選擇哪種方式取決于芯片的設(shè)計(jì)需求、性能要求以及成本考慮。
聯(lián)系方式:鄒先生
座機(jī):0755-83888366-8022
手機(jī):18123972950(微信同號)
QQ:2880195519
聯(lián)系地址:深圳市龍華區(qū)英泰科匯廣場2棟1902
搜索微信公眾號:“KIA半導(dǎo)體”或掃碼關(guān)注官方微信公眾號
關(guān)注官方微信公眾號:提供 MOS管 技術(shù)支持
免責(zé)聲明:網(wǎng)站部分圖文來源其它出處,如有侵權(quán)請聯(lián)系刪除。
